
| IGBT的芯片结构及失效模式 |
一、IGBT的结构
1.芯片结构和特征
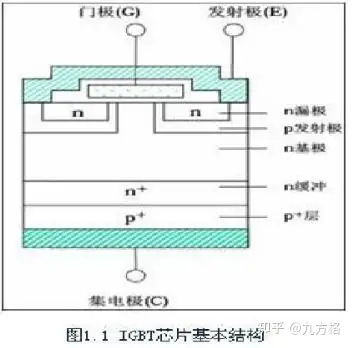
2. IGBT芯片结构的变迁
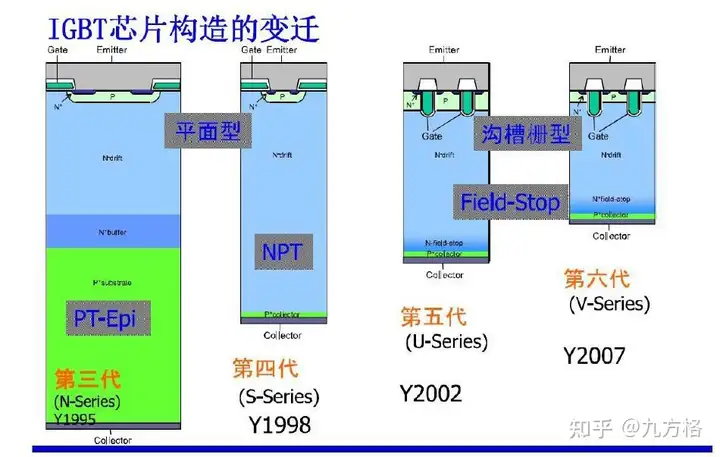
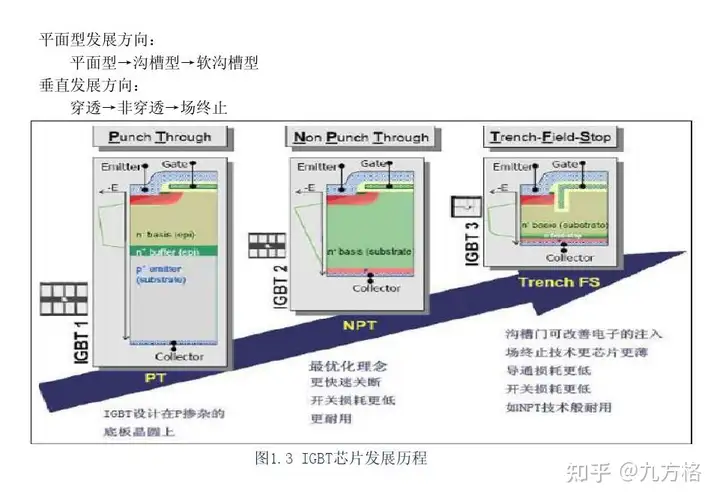
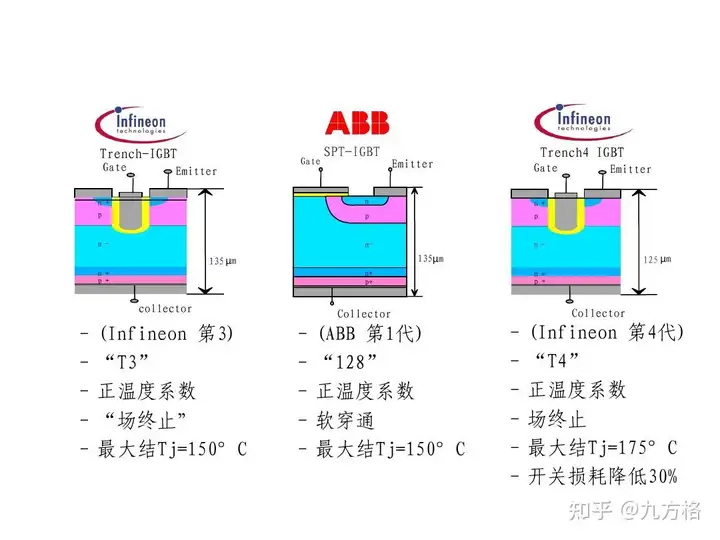 0
0
3. IGBT芯片的结构和封装流程

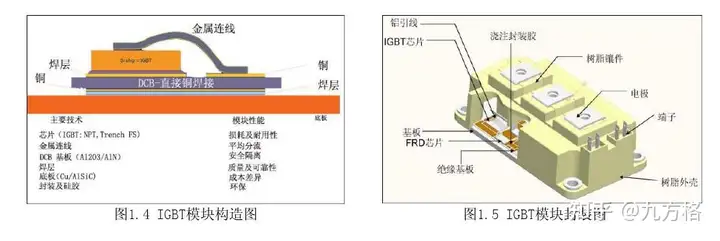

A模块实际需求的电路图
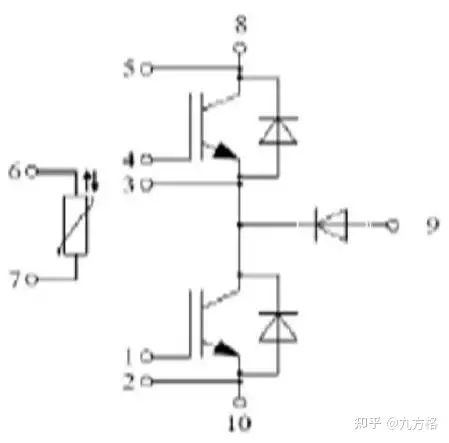
B模块实际需求的电路图
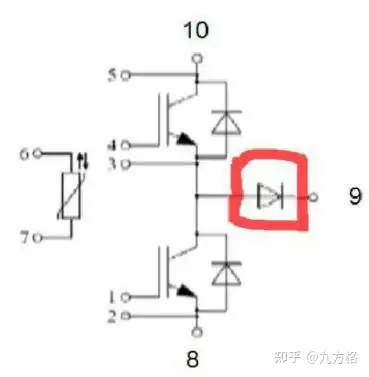
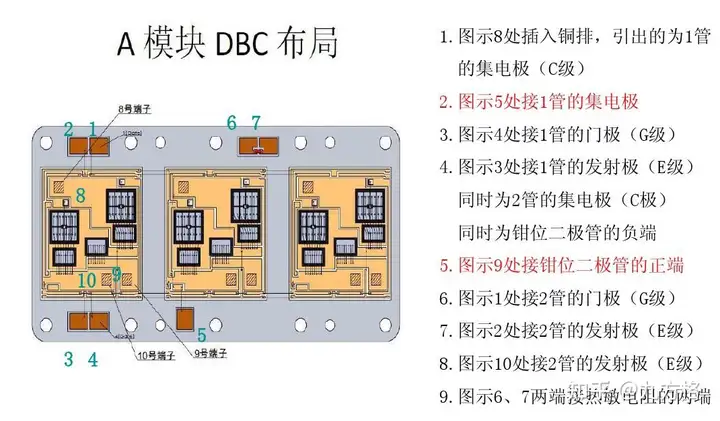

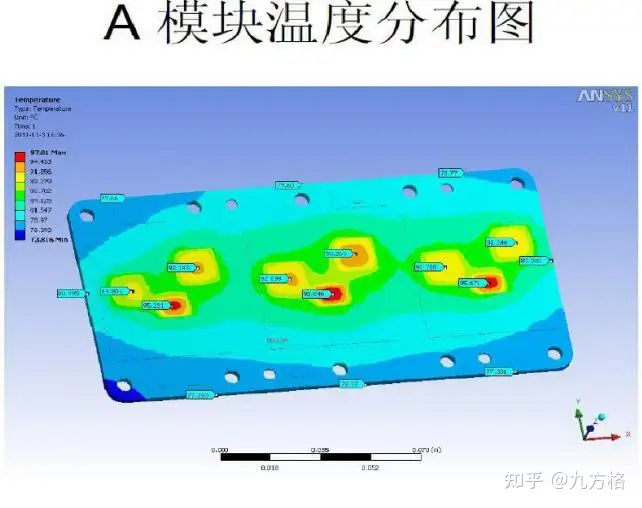

七单元系列
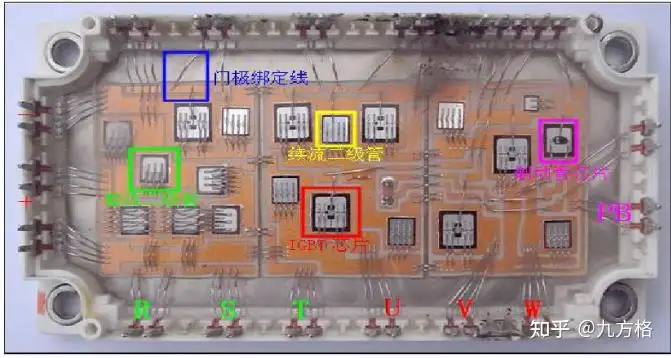
六单元系列
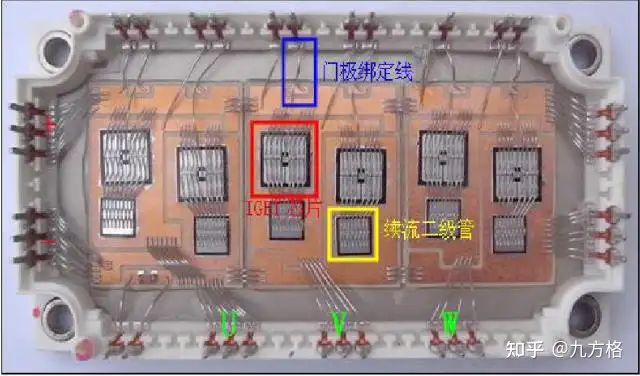
两单元系列
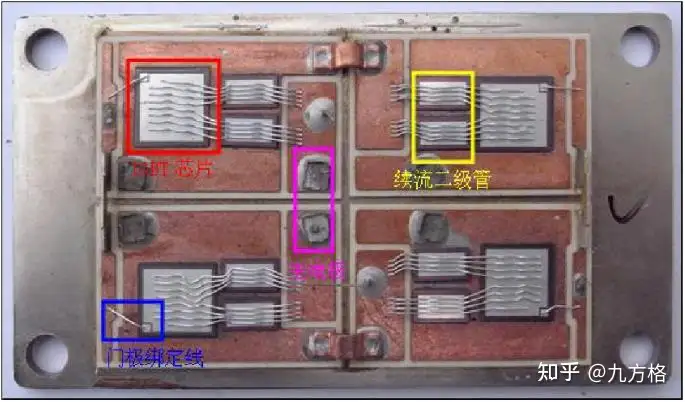
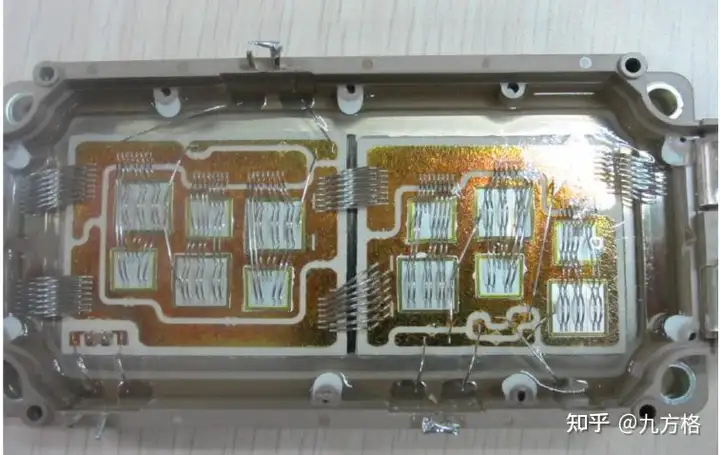
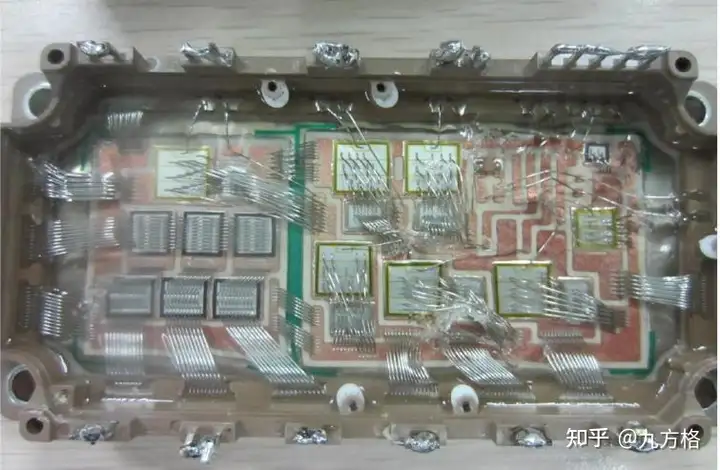
二、IGBT常见的失效模式
1. IGBT失效机理
和其它任何功率半导体器件一样,IGBT工作的应用可靠性极大程度上依赖于对结温TJ的控制,其失效率随结温的递增几乎呈指数递增的关系。
因此,过温失效时IGBT的最重要失效模式。
为了获得尽可能低的通态压降,IGBT选用的硅单晶电阻率及设计的芯片基区宽度都是被控制在尽可能小的范围,这决定了IGBT的集电极额定击穿电压并不像工频器件那样可有较大的余量,因此当IGBT承受的电压超过其额定值时极有可能造成永久性损坏---电压击穿失效。
当IGBT关断过高的脉冲集电极电流ICM时同样可能产生较高的集电极电压VCE而产生电压击穿失效。
多数器件制造商推荐的IGBT工作电压VCE的上限值为80%额定电压。
IGBT的栅极和MOSFET一样多属于MOS(金属-氧化物-半导体)结构,当栅极引入过电压时可导致栅氧层的缺陷产生或直接击穿而使IGBT失效--栅极过电压失效。
另外,当IGBT栅极引入高电压时,集电极电流会跟随变大,关断这个电流而产生的集电极过电压(VCE)有可能使集电极产生击穿--栅极过电压引起的集电极过电压失效。
2.常见的失效原因
.过电压:
VCE过电压
•关断浪涌电压
•母线电压上升
•控制信号异常
•外部浪涌电压(雷电浪涌等)
VGE过电压
•静电
•栅极驱动回路异常
•栅极震荡
•与高压相连
•外部浪涌
过流、热失效:
散热设计不完善
短路
过电流
栅极电压欠压
极配线开路
开关频率异常增加
开关时间过长
散热不良
功率循环与热循环:
过大的温度变化
过频繁的温度变化
3.一些失效案例
A、过压失效
故障点靠近硅片边沿或传感器,其电场较强。
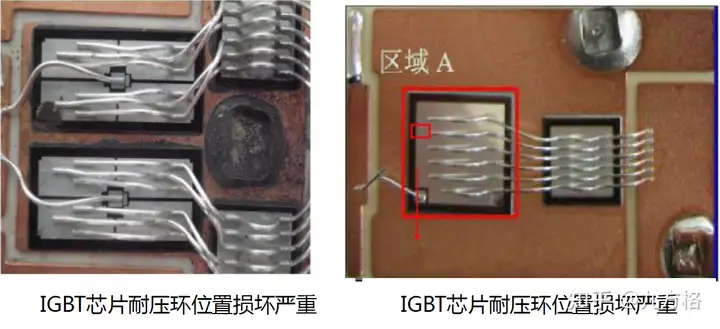
3.一些失效案例
A、过压失效
故障点靠近硅片边沿或传感器,其电场较强。

综述:IGBT芯片铝线和芯片表面键合位置为绑线点,当此位置出现类似现象时,可以判定为过电流损坏。
损坏的原因一般有以下几种:
1、输出短路或输出接地;
2、母线铜牌大火导致浪涌电流;
3、门极控制信号异常(有干扰源或者本身器件损坏)
B、过流失效
故障点集中于绑定线区域,因为短路电流流向是从背部的“C”到绑定线部位的“E”
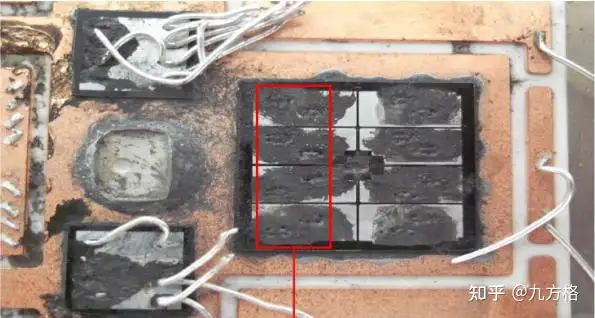


综述:IGBT芯片铝线和芯片表面键合位置为绑线点,当此位置出现类似现象时,可以判定为过电流损坏。
损坏的原因一般有以下几种:
1、输出短路或输出接地;
2、母线铜牌打火导致浪涌电流;
3、门极控制信号异常(有干扰源或者本身器件损坏)
C、过热失效
故障点位于硅片中心附近,该区域发热严重。
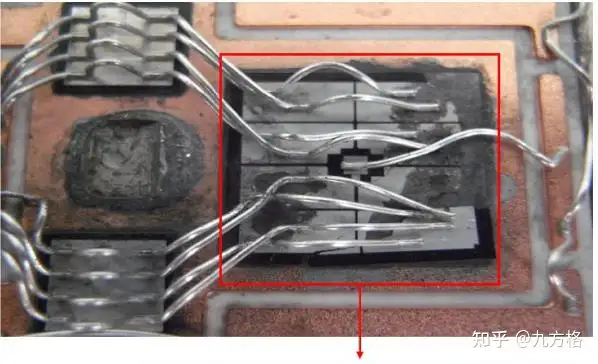
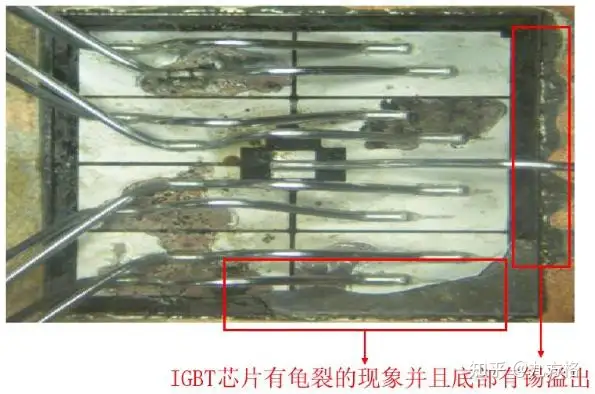

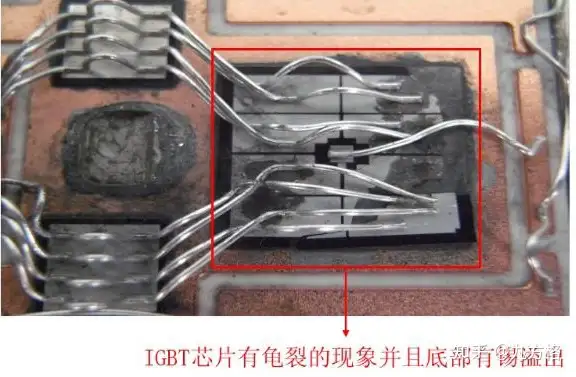

综述:IGBT芯片有龟裂或者表面有熔融的球状物,出现此类现象时,可以判定为过电流损坏。
损坏的原因一般有以下几种:
1、瞬间通过极大电流导致瞬时结温过高;
2、散热不良,或者散热硅脂涂抹不到位;
3、器件本身空洞率过高
D、门极过电压
故障点位于栅氧化层,由于栅氧化层几乎分布在硅片的每个部位,所以故障点可能随机出现在硅片的任意地方。
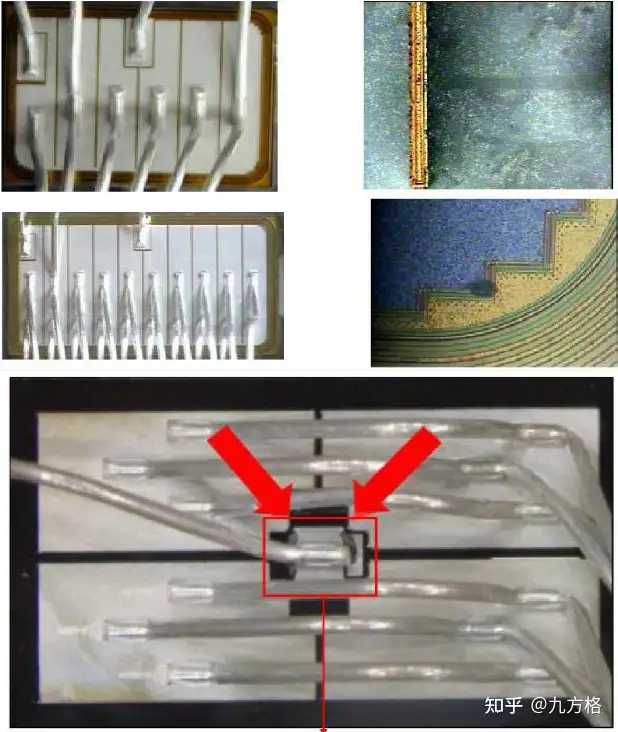

损坏的原因一般有以下几种:
1、静电击穿;
2、门极有较大的电压震荡;
3、驱动电路有浪涌信号通过;
D、功率循环疲劳
键合线从硅片脱落。
由于热膨胀系数的不同而产生的应力,导致铝线剥落。

E、热循环疲劳
位于底板和绝缘基片间的焊接层破裂,这是由于热膨胀系数的不同而产生的应力所导致